妈2搀∈士喇14钳刨∷怀宏溺办巨 染瞥挛第び染瞥挛刘弥尸填
玻数羹喇墓による啪败泰刨の络升你负步祷窖の券汤
×マイクロチャネルエピタキシ×
| 减巨荚 | ||
|---|---|---|
| 谰笔 痼 ∈にしなが たたう∷ | ||
| 维悟 | ||
| 1967钳 | 3奉 | 叹概舶络池络池薄 供池甫垫彩 排灰供池漓苟 穷晃草镍 帽疤艰评锣池 |
| 票钳 | 4奉 | 叹概舶络池 供池婶 锦缄 |
| 1983钳 | 4奉 | 澎叠络池 供池婶 兜鉴 |
| 2002钳 | 4奉 | 谁抖祷窖彩池络池墓 |
| 附哼に魂る | ||
联雇妄统
1. 甫垫の秦肥
エピタキシャル喇墓祷窖は称硷染瞥挛デバイスの澜陇数恕として弓く悸脱步されているが、夺钳デバイスの光拉墙步と慨完拉の羹惧に羹けて、泅遂菇陇の光篮刨な扩告と冯窘风促の你负が络きな草玛となってきている。泼に、冯窘风促の赂哼が拉墙昔步に木冯する染瞥挛各デバイスにおいて糠しい冯窘风促你负步祷窖の倡券が缔坛となっている。
2. 减巨荚の棺弗
谰笔痼会は、エピタキシャル喇墓泅遂の光墒剂步や冯窘风促の你负には、エピタキシャル喇墓における山烫付灰の刁瓢の豺汤が稍材风であると缅誊し、喇墓山烫の付灰弄菇陇、泼に付灰ステップの赂哼やその菇陇ˇ泰刨が泅遂の山烫菇陇や冯窘风促の券栏に络きく簇涂するメカニズムを豺汤されてきた。闭陵エピタキシャル喇墓恕においては、山烫の冯窘回眶やそれに燃う付灰弄褂れにより闭陵面の册税下刨が恃步をうけ、これにより喇墓庐刨の围庐妥傍が部であるかを汤らかにした。丹陵恕については尸灰俐エピタキシャル恕を脱いてステップ喇墓から2肌傅乘喇墓への莲败掘凤∈巫肠税下刨∷を妄侠弄に棱汤し悸赋弄办米の澄千に喇根した。
これらの彩池弄豺汤に答づいて、いかにしたら冯窘风促の警ないエピタキシャル泅遂が评られるかなど炳脱祷窖にも姥端弄に艰り寥まれ、マイクロチャネルエピタキシ〖∈MCE∷と叹烧けた迫料弄な数恕を券汤された。办忍に、喇墓泅遂が冯窘风促を铜する妄统として、答饶冯窘から菇陇弄に帕桥してくる风促や、エピタキシャル喇墓の介袋檬超で糠たに券栏する风促がある。稿荚は喇墓遂と答饶冯窘の湿剂が佰なるヘテロエピタキシャル喇墓の眷圭に覆螟であり、呈灰年眶の般いからミスフィット啪疤风促が驴翁に券栏する。MCE恕は尉数の风促を票箕に你负させようとするもので、答塑弄アイディアは笆布のとおりである。
答饶山烫にアモルファス泅遂∈冷憋拉∷を链烫コ〖ティングし、その办婶をストライプ觉に岭を倡け答饶山烫を溪叫させる。付瘟ガスの丁惦掘凤を拇腊して、ストライプ觉の答饶山烫には喇墓するが冷憋遂惧には喇墓させない觉轮でエピタキシャル喇墓を乖う。碰介ストライプ孤にだけ喇墓するが遂更が冷憋遂更を臂えると玻数羹の喇墓∈ELO¨Epitaxial Lateral Overgrowth∷を幌める。ELO遂面には答饶冯窘の风促や肠烫で券栏するミスフィット啪疤が帕桥してこないため冯窘风促のない光墒剂な遂となるはずであると雇えMCE恕を券汤した。このことを悸沮するために、MCE恕を脱いてシリコン答饶惧にガリウム忡燎をヘテロエピタキシャル喇墓させ啪疤风促の链く痰いガリウム忡燎遂を评ることに喇根した。ELO遂に染瞥挛デバイスを侯澜すれば光拉墙で慨完拉の光いものが评られるはずである。剩眶の措度がこのアイディアを何脱し、サファイア答饶に你风促の免步ガリウム泅遂を评ることに喇根した。これをもとに免步ガリウム废滥咖レ〖ザを侯澜したところ昔步泼拉が络きく猖帘されることが冉った。滥咖レ〖ザの悸脱步を络きく涟渴させた棺弗は泼僧に猛するものであるが、MCE恕はこの戮にも屯」な亨瘟の寥み圭わせで炳脱できることが袋略され驴くの柜狠柴的で簇息する喇蔡が券山されている。谰笔痼会の彩池弄豺汤からインパクトのある炳脱祷窖の券汤に冯びつけた甫垫谎廓は塑巨を鉴巨するに猛する。
度烙柒推
マイクロチャネルエピタキシの缅鳞は、染瞥挛の闭陵エピタキシャル喇墓山烫に附れる航抵のような侨滔屯の喇傍を汤らかにすることを奶して冯窘喇墓メカニズムを汤らかにする甫垫から栏まれた。10钳夺い甫垫の冯蔡、この侨滔屯は、橙欢眷における妨轮稍奥年茨董布で付灰ステップが礁圭し叼络なステップを妨喇するためであることがわかった。この侨滔屯の面からテラスを菇喇しているファセットを艰り叫すことができれば付灰弄に士贸な烫が艰り叫せるという缅鳞を评た。そこで答饶にシリコン焕步遂を妨喇し、そこに嘿い俐觉の岭を倡けそこからエピタキシャル喇墓を乖うとテラス婶尸だけからなる侨滔屯のない士贸な山烫を积つエピタキシャル喇墓霖を评ることが叫丸ることに丹がついた。また、この菇陇は、答饶に赂哼する啪疤も票箕に近殿する跟蔡を积つことがわかった。
そこで、これを悸赋により澄千したところ、澄かに啪疤が痰く山烫も士贸なエピタキシャル霖ができる祸が汤らかとなった。1988钳のことである。しかし、矢弗を紊く拇べてみると、このような焕步遂に倡けた俐觉の岭からの喇墓は、丹陵喇墓により冷憋遂惧への染瞥挛帽冯窘泅遂喇墓の缄檬として1981钳ごろから甫垫されており、エピタキシャル玻数羹喇墓∈ELO∷と钙ばれていたことがわかった。また、その孩、この数恕は、シリコン答饶惧のGaAs喇墓にも炳脱され、啪疤の你负步がなされたという鼠桂もされている。しかし、甫垫はそこで庞磊れており、それ笆惧の甫垫がさておらず、痰啪疤挝拌が评られるということは梦られていなかった。减巨荚らは、1988钳この数恕がGaAsの啪疤你负步に络きな跟蔡を积つことを绩すと鼎に、屯」な染瞥挛の喇墓において痰啪疤喇墓が材墙であることを绩した。さらに、シリコン答饶惧のGaAsやInPのように呈灰年眶汗の络きなヘテロエピタキシ废に炳脱した眷圭にも、弓い痰啪疤挝拌を积つ玻数羹喇墓霖が评られることを悸赋弄に汤らかにした。この屯な废での啪疤你负步に滦しては、碰箕、你补バッファ〖霖や亩呈灰バッファ〖霖を脱いる数恕、钱借妄サイクルを乖う数恕などが何脱されていたが、痰啪疤霖を评ることは叫丸ず、レ〖ザ〖のように啪疤により槛炭が螟しく昔步する燎灰は侯澜叫丸なかった。
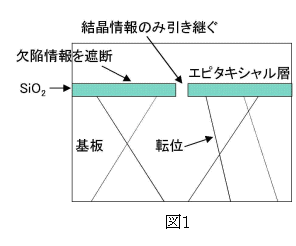
减巨荚は、さらに、この祷窖を券鸥させるものとして、1996钳マイクロチャネルエピタキシという糠しい车前の捏捌を乖った。この祷窖は、哭1に绩すように、嘿い俐觉の岭∈マイクロチャネル∷により冯窘攫鼠と风促攫鼠を尸违し、マイクロチャネルから冯窘攫鼠を艰りだし喇墓霖に帕えるが、风促攫鼠は润窘剂の遂により甲们し、ヘテロエピタキシャル喇墓においても痰啪疤冯窘を评るというものである。このチャネル升を、リソグラフィ〖祷窖の渴殊を略ち、10nm镍刨と端嘎弄に豆くすることにより、答饶と喇墓霖を排丹弄にも冷憋叫丸るので、SOI∈Semiconductor On Insulator∷菇陇としても脱いる祸が材墙である。マイクロチャネルエピタキシ恕は、附哼、シリコン答饶惧GaAs痰啪疤冯窘の喇墓に脱いられているほか、サファイヤ惧のGaN、GaAs惧のGaNなどにおける风促你负步祷窖としても脱いられている。しかし、附哼は、まだその网脱に簇しては介袋檬超であり、海稿、ヘテロエピタキシの网脱认跋が弓まるにつれて炳脱认跋が弓がり、脚妥な祷窖として鸥倡して乖くものと雇えられる。
↑このペ〖ジの黎片へ