特徴
ロックイン発熱解析法は、電流経路中の僅かな温度上昇を検出します。
- IR-OBIRCH機能も合わせ持ち、発熱箇所特定後、IR-OBIRCH測定により、故障箇所をさらに絞り込むことができます。
- ロックイン信号を用いることにより高いS/Nで発熱箇所を特定でき、Slice & Viewなど断面解析を行うことができます。
- 赤外線を検出するため、エッチングによる開封作業や電極の除去を行うことなく、パッケージのまま電極除去なしに非破壊での故障箇所特定が可能です。
適用例
症状
- 配線間リークやショート不良
- 発光素子の発熱面内分布測定
- 発光素子の発熱面内分布測定
- 静電破壊箇所の特定
- 酸化膜のマイクロプラズマリーク・絶縁不良
デバイス
- Siデバイス(トランジスタ・MOSFET・IGBT・CMOSセンサ)
- GaN発光素子・GaNデバイス(LD・LED・HEMTなど)
- SiCパワーデバイス(ショットキーバリアダイオード・MOSFETなど)
- MEMS(圧力センサ・加速度センサ)
- IC、基板などの絶縁劣化部位の特定
原理
デバイスの内部で発生する熱を検出し、故障箇所を特定する半導体故障解析装置となります。高感度赤外検出器にて検出した発熱画像と、IRコンフォーカルレーザ顕微鏡で取得した高解像度なパターン画像を重ね合わせて表示することにより、高感度かつ高い位置精度で故障箇所を迅速に特定します。
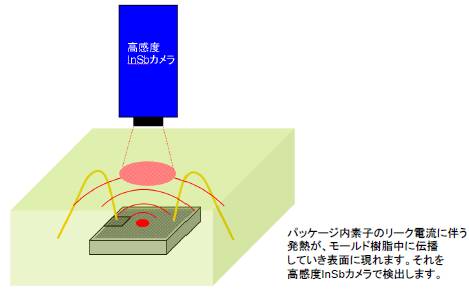
データ例
パワーMOSFET G-S間ショート箇所の特定
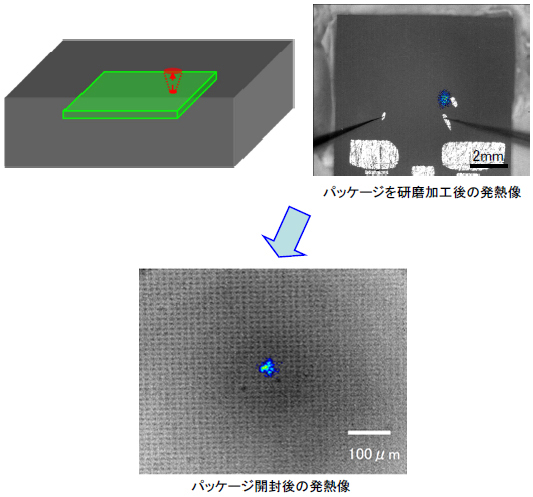
データ形式
- TIFFファイル(1,027KB): 生データ
※必要な場合は別途ご相談ください。 - JPEGファイル(約600KB): 処理データ
※処理データは試料名・印加条件・倍率(スケールバー)などの記載を行います。
仕様
| 搬入可能試料サイズ | 直径150mmφ×高さ50mm |
| 測定視野 | 12mm×9.6mm、1.2mm×0.96mm |
| 最大印加電圧 | 600V |
| ロックイン周波数 | 0.2~25Hz |
| 倍率 | 対物レンズ:×0.8,×8 |
| 位置精度 | 5μm~ |
| 温度検出能力 | 20 mK |
必要情報
- 目的/測定内容
- 試料情報
(1)数量、予備試料の有無など
(2)印加条件
(3)耐圧 - 納期
(1)ご希望の速報納期
(2)その他の留意点 - その他の留意点
注意点
以下の材料は測定に悪い影響を及ぼします。
- 熱伝導率が非常に高い
- 発熱量が小さいもの

