第12回(平成24年度)山崎貞一賞 半導体及び半導体装置分野
Si MOSFETのチャネル内キャリア輸送特性の解明と高移動度化への先駆的貢献
| 受賞者 | ||
|---|---|---|
| 高木 信一 (たかぎ しんいち) | ||
| 略歴 | ||
| 1983年 | 3月 | 東京大学 工学系研究科 博士課程 修了 |
| 同年 | 4月 | (株)東芝 総合研究所 入所 |
| 1993年 | 8月 | スタンフォード大学 客員研究員 |
| 1995年 | 4月 | (株)東芝 研究開発センター 研究主務 |
| 2001年 | 8月 | 半導体MIRAIプロジェクト 「新構造トランジスタ及び 計測解析技術グループ」 グループリーダ兼務 |
| 2003年 | 10月 | 東京大学大学院 工学系研究科 教授 |
| 現在に至る | ||
授賞理由
高木信一氏は、1980年代後半から現在に至るまで、一貫してMOSFETの高移動度化に関する研究で世界に強い影響を与えてきた数少ない研究者である。すなわち、高木氏は、1988年、MOSFETの速度を支配する反転層内のキャリア輸送特性を実験と理論の両面から系統的・包括的に検討し、これを基に、微細MOSFETの移動度の評価法や高移動度化への指針を与えたのみならず、普遍性・有用性の高いデバイスモデルの構築を可能とした。氏の提唱した移動度モデルは、いまや多くの市販シミュレータに組み込まれ、試作が益々困難になっている微細MOSFETの性能予測を可能にし、産業的貢献も大きい。さらに高木氏は、1990年代中頃、歪Si MOSFETにおける移動度向上の物理的起源を理論と実験の両面から初めて明らかにし、2003年頃に始まった歪Si MOSFETの最適構造の設計に貢献していることは、氏の関連論文が世界的に広く引用されていることからうかがえる。また、この解明に基づき、移動度を向上させるコンセプトを継続的に提唱し、薄膜SOIなど多様な新構造MOSFETに適用し、本分野を牽引してきている。
高木氏の国際学会における多数の論文・講演(158件)や顕著な表彰は、氏の独創性・先見性・リーダシップを示す証左で、すでに国際的知名度が高い。氏の研究は、実験と理論が高度にバランスし、かつ実用性に富み普遍性が高いので、今後も、高移動度チャネルMOSFETの高度化に重要な役割を果たすものと思われる。
以上、基礎研究で学界・産業界に与えてきた氏の社会的影響の大きさを評価し、高木信一氏を第12回山崎貞一賞半導体及び半導体装置分野の受賞者とする。
研究開発の背景
半導体集積回路(ULSI)は、50年以上の長期に渡り、素子の微細化を通じて、高性能化・高機能化を実現してきた。このような技術発展の基礎には、ULSIの構成要素であるSi MOSトランジスタの高電流駆動力化がある。Si MOSトランジスタの電流を決める重要な物理量の一つが、チャネルとなるSi反転層中のキャリア移動度である。このことから、MOSFETの駆動電流を向上させるためには、チャネル移動度を決定している物理的起源を明らかにし、その定量的モデルを構築すると共に、チャネル移動度を向上できるエンジニアリング手法を提案・確立することが極めて重要となっている。
業績内容
本研究では、MOSFETのチャネル移動度の重要性に鑑み、Si MOSFETの反転層中の電子および正孔移動度を、MOS界面の垂直電界、基板濃度、温度、面方位などを変えながら実験的・系統的に調べることで、その特性を明らかにした。その結果、図1に模式的に示すように、MOS界面の平均的垂直電界である実効電界Eeffという物理量を用いることにより、チャネル移動度を、「ユニバーサル移動度」として、統一的に記述できることを明らか
にすると共に、移動度決定の物理的起源を定量的に明らかにすることに成功した。
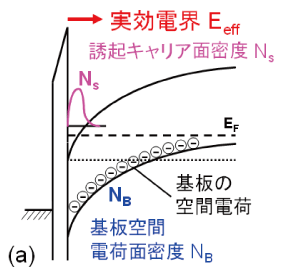
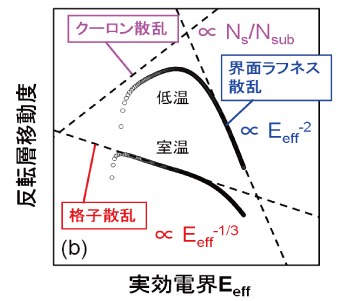
図1 (a) Si MOS界面のバンド模式図
(b) 移動度の実効電界依存性と移動度を決定している散乱機構の模式図
Si MOS反転層のキャリアは、MOS界面に強く閉じ込められており、2次元サブバンドという構造を取ることが知られている。特に、(100) 面Siの反転層中の電子は、二重縮退バレーおよび四重縮退バレーと呼ばれる2つの電子状態に帰属している。本研究では、この特性に基づき、移動度を向上させるエンジニアリング手法として、図2に示すように、電気伝導特性に優れた二重縮退バレーの電子状態のエネルギーレベルを、四重縮退バレーの電子状態よりも引き下げ、二重縮退バレーの電子の数を増やすことにより、MOSFETの電流駆動力を向上させる、サブバンド構造変調技術を提案した。この構造変調は、Siチャネルに引張りひずみを印加することにより実現できる。この、ひずみを印加した場合のMOSチャネル中の電子移動度向上の物理的起源に対して、サブバンド構造変調の観点から定量的な説明を与えることに成功した。また、異なるサブバンド構造変調方法として、SOI(Si-On-Insulator)という素子構造においてSi膜厚を極めて薄くすることにより、四重縮退バレーの閉じ込めエネルギーを上昇させ、移動度を向上させる方法を提案し、理論的解析を行うと共にその実証を行った。 更に、ひずみによる移動度向上を微細化に適した素子構造であるSOI構造と組み合わせた、ひずみSOI素子構造(図3)を提案し、デバイス動作およびひずみSi MOSFETから構成されるCMOS回路動作の優れた特性を世界に先駆けて実証した。
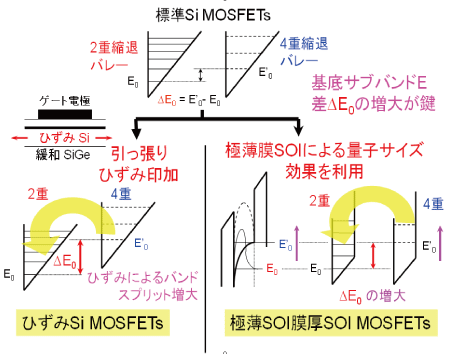
図2 Si MOS反転層のサブバンド構造変調技術の模式図
その後も、高電流駆動力をもつ将来のMOSトランジスタ実現に向けて、MOS反転層移動度やサブバンド構造の物理的理解に基づき、有効質量の軽いGeやIII-V族化合物半導体をチャネルに用いたMOSトランジスタ技術の研究を継続している。
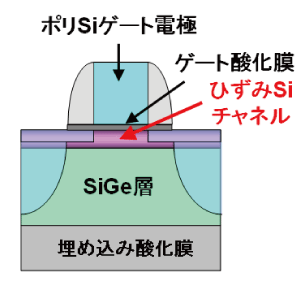
図3 ひずみSOI MOSFETの断面構造図
本業績の意義
本研究において得られた「ユニバーサル移動度」は、Si MOSトランジスタの移動度に関してレファレンスとなるデータとして、またSi MOS反転層移動度の物理的機構を理解する上での基本的枠組みとして、国際的に広く活用されると共に、デバイスシミュレータの物理モデルとしても一般的に用いられている。
また、Siの材料物性としての物理的限界を背景に、2000年以降、MOSFETの微細化技術の行き詰まりが認識され、MOSFETの移動度向上技術、特にひずみSiチャネル技術が真剣に検討された。本研究では、産業界においてひずみSiチャネルの研究開発が活性化する以前に、ひずみSi MOSFETの解析・実証に着手し、その移動度向上機構を明確化すると共に、ひずみSOI MOSFETやひずみSOI CMOSの回路動作を世界に先駆けて実証することなどを通じて、ひずみSi技術の実用化に大きく貢献した。
またSiチャネルで得られた知見を発展させ、将来のMOSFETとして、現在高い関心が集まっている、GeやIII-V族化合物半導体を用いたMOSデバイス技術の研究開発を継続しており、極微細世代のULSI実現に向けた、素子技術の発展に貢献している。
