EBSD: 電子後方散乱回折法
透過EBSD法による空間分解能の向上
通常EBSDは70度程度傾斜させたバルク試料に電子線を照射し後方散乱電子回折を解析していますが、この測定方法では電子線の広がりから50nm以下の結晶粒の評価は困難となります。試料を薄片化し電子線を透過させることで50nm以下の微小な結晶粒も評価可能となります。※
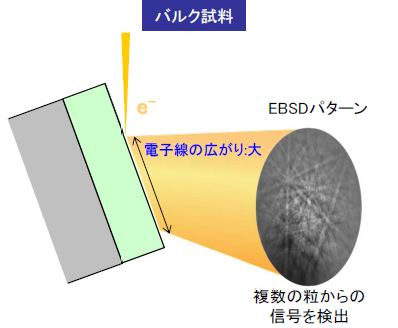

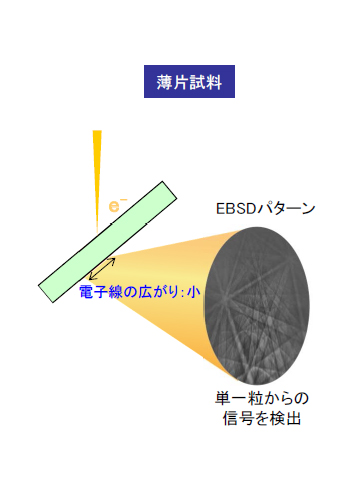

※)引用: R. R. Keller, R.H. Geiss : “Transmission EBSD from 10 nm domains in a scanning electron microscope”,Journal of Microscopy, Vol. 245, Pt 3 2012, pp. 245–251