赤外吸収法によりSiN膜中のSi-H,N-Hを定量
概要
SiN膜中のSi-H及びN-H濃度をFT-IR分析により求めることが可能です。SIMS等の分析でも、水素濃度を求めることは可能ですが、全水素濃度であり、Siと結合した水素及びNと結合した水素をそれぞれ求めることは出来ません。FT-IRではSi-H伸縮振動とN-H伸縮振動が別の位置にピークを持つため、それらのピークを利用して、それぞれの水素濃度を求めることが出来ます。
Si基板上SiN膜中のSi-H及びN-H濃度を求めた分析事例を下記に示します。
データ
測定(真空透過法)
大気中成分の影響を軽減するために真空下での透過法で測定を行います。
SiN膜のついていないSi基板をリファレンスとして、SiN膜/Si基板からSi基板分を差し引きすることによりSiN膜のFT-IRスペクトルを得ます。
※Si基板は不純物の少ない高抵抗のものが適しています。
SiN膜は数十nmと薄い場合、解析できない可能性があります。
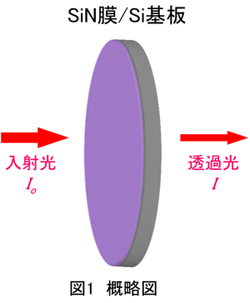
FT-IRスペクトル及び定量結果
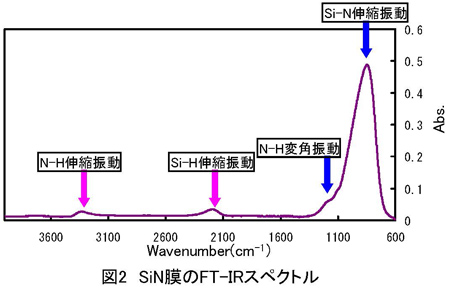

SiN膜のベースライン補正後のFT-IRスペクトルを図2に示します。また、矢印で示した各ピークの推定される帰属も示します。N-H伸縮振動及びSi-H伸縮振動のピークと膜厚を用いて算出したN-H及びSi-Hの定量結果を図3に示します。