XAFSとXPSの複合解析によって高精度なバンドギャップ評価が可能
概要
薄膜試料のバンドギャップはこれまでUV-Vis・PL・XPSなどの分析手法で測定されてきましたが、材料・膜厚・基板などの試料構造の制約から評価可能なケースが限られていました。
今回、XAFSとXPSの複合解析によって、試料構造の制約を少なく、かつ従来よりも高精度なバンドギャップ評価が可能となりました。本手法は特に各種酸化膜・窒化膜の評価に対して有効です。
本資料では窒化シリコン(SiN)膜のバンドギャップ評価事例をご紹介します。
データ
本手法の特長
- 試料構造の制約が少ない(薄膜(20nm以上)、任意の基板上の成膜でも評価可能)
- 幅広いバンドギャップ値を評価可能(~10eV程度)
- 値の算出における不確かさが小さく、従来よりも高精度な評価が可能
窒化シリコン(SiN)膜の測定事例
SiN膜の価電子帯(XPS)、X線吸収スペクトル(XAFS)

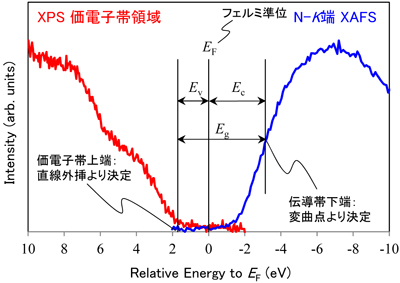
SiN膜のバンド構造

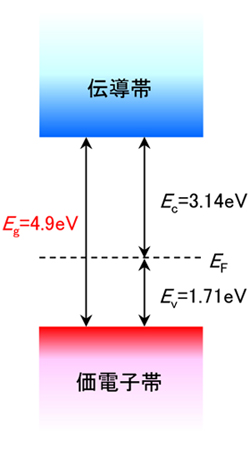
参考文献:S. Toyoda, et al., Appl. Phys. Lett. 87, 102901 (2005).
各種酸化膜、窒化膜のバンドギャップ評価に有効です