エッチングプロセスにおける原子レベルでの表面反応の理解に有効
概要
半導体プロセスの微細化に伴い、エッチングガス、ALD成膜におけるプリカーサ、プラズマ処理などによる表面反応の重要性が増しています。このようなエッチング、表面結合状態変化、欠陥生成などの複雑な化学反応が関与する系に対して、原子レベルでの現象の理解には分子動力学計算を用いた解析が有効です。
本資料では、a-SiO2のHFエッチング反応について、分子動力学計算から評価しました。様々な反応、材料に対して同様のアプローチが適用可能です。
データ
計算モデル、HFエッチングシミュレーション結果
HF分子を順にa-SiO2表面で反応させることで、エッチング反応をシミュレートしました。反応したHF分子数をnとしています。(n=0~300)


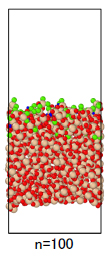
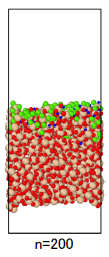
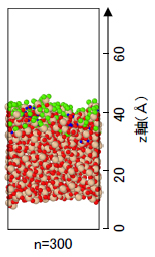
エッチング時の膜のSi組成分布、xy面内の局所応力分布
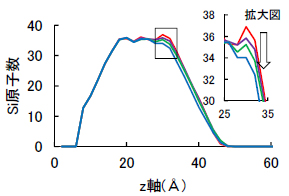
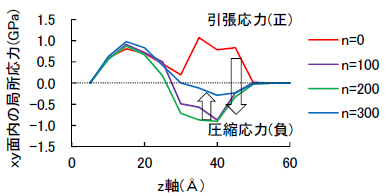
- 反応したHF分子数の増加に伴い、表面Si原子数が減り、膜のエッチングが進むことが分かります。
- フッ化により表面近傍で圧縮応力が強くなる傾向が見られました。圧縮応力の大きさは1GPa程度となり、エッチング時の膜の変形要因となることが示唆されます。
- エッチングが進むことにより、圧縮応力が緩和される様子が見られました。原子の再配置が起こり、応力が緩和したと考えられます。