不純物元素の定量評価及び膜厚評価が可能です
概要
ダイヤモンドは高絶縁破壊電界など優れた物性を有するため、次世代のパワーデバイスや量子デバイス材料として期待されています。ダイヤモンドへ不純物元素をドープすることにより高性能な半導体として機能します。ドープした元素の濃度分布を把握するには, ppb~ppmオーダーの不純物を高感度で検出可能なSIMS分析が有効です。あわせて不純物の濃度分布から各層の膜厚評価も可能です。MSTでは、ダイヤモンド標準試料を取り揃えており、30種類以上の元素について定量することができます。
データ
今回評価に用いたバイポーラトランジスタの構造を図1に、分析事例を図2に示します。
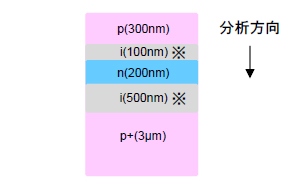 図1 試料断面模式図
図1 試料断面模式図※ 不純物がドープされていないダイヤモンド半導体
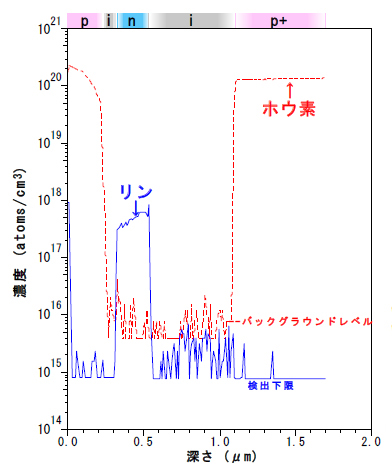 図2 ダイヤモンド中ホウ素、リンのデプスプロファイル
図2 ダイヤモンド中ホウ素、リンのデプスプロファイルホウ素、リン以外にも
30種類以上の元素の定量が可能です。
お気軽にお問合わせください。
分析仕様
一次イオン種:Cs+
測定領域:125μm×125μm
【参考文献】NEW DIAMOND誌第113号 Vol.30 No.2 P.44
サンプルご提供
国立研究開発法人産業技術総合研究所 小倉 政彦 様, 加藤 宙光 様