硬X線光電子分光法(Cr線)
:HArd X-ray PhotoElectron Spectroscopy
[HAXPES]硬X線光電子分光法の
分析事例はこちらからご覧ください。
特徴
HAXPESは、XPS(X線光電子分光)の励起光に硬X線を用いた分析手法です。
HX-PES、HXPESとも呼ばれます。
この装置はCr Kα線源(5.41keV)の高エネルギーなX線励起により通常のXPSより深い30nm程度までのバルク中の評価、ダメージレスな界面の評価を行うことができます。
また、同一チャンバー内で同じ箇所のXPS(Al Kα線)測定を行うことも可能です。
- 固体のバルク中(約30nm)の元素の定性・定量
- 化学結合状態分析
- 非破壊で界面の評価
- 狭い領域(100μmφ )での評価
- 深さ方向分布(Arモノマー/GCIBスパッタを併用)の評価
- 大気非暴露下での評価
適用例
- リチウムイオン電池Si系負極材、正極金属酸化物のバルク状態評価
- ゲート絶縁膜、キャパシタ材料の界面状態評価
- 金属腐食表面の深さ方向状態変化
- コアシェル型ナノ粒子の結合状態評価
- 有機物のバルク状態評価
原理
HAXPESは、硬X線照射により放出される光電子の運動エネルギー分布を測定します。
光電子の発生原理は以下の通りです。照射X線のエネルギーと光電子の運動エネルギーから束縛エネルギーを算出することができます((1)式)。
Ebは元素およびその電子状態等に固有な値であるため、この値から試料中の元素の同定およびその化学結合状態に関する知見を得ることができます。
Eb=hn-Ek (1)式
Eb:電子の束縛エネルギー
hn:照射X線のエネルギー
Ek:光電子の運動エネルギー
HAXPESとXPSでは、検出深さが異なります。
検出深さは、放出される光電子の平均自由行程λ に依存し、同材料中では、λは光電子の運動エネルギーEkが大きいほど長くなります。
HAXPESでは、入射X線に高いエネルギーを持つ硬X線(Cr Kα:5.41 keV)を用いることで、通常のXPS(Al Kα:1.49keV)よりも試料の深い位置からの情報を得る事が可能となります。
装置構成
その他のオプション
- モノクロAl,Mg線源
- Arイオン(モノマ-)銃
- 大気非暴露機構(Ar)
- 中和銃
- GCIBイオン銃
- 加熱機構(~600℃まで)
データ例
ワイドスペクトル(定性評価) 測定例:SiO2(25nm)/Si基板
ナロースペクトル1 (深い位置にある界面の結合状態評価)測定例:SiO2(25nm)/Si基板
※結合状態だけでなく、定量評価も可能
| Si1s(Cr線) |
Si2p(Al線) |
 |
 |
ナロースペクトル2 (オージェピークの重複を回避した評価) 測定例:GaN
| Cr線:ピークの重なりが無く、詳細な評価が可能 |
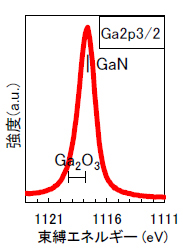 |
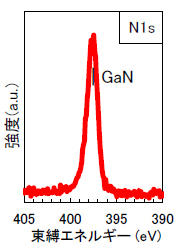 |
| Al線:NにGaオージェピークが重なる |
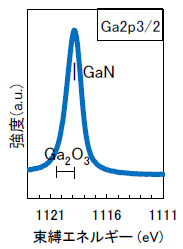 |
 |
データ形式
- PDFファイル:ナロースペクトル(化学結合状態)、波形分離等
- Excelファイル: 光電子スペクトルの数値データ等
仕様
| 検出可能元素 |
原子番号3(Li)以上の全元素 |
| 搬入可能試料サイズ |
80mm×80mm, 高さ5mm程度まで(高さ5~20mmの場合は40mm角以下)
※オプション仕様の際は別途ご相談ください |
| 測定可能領域 |
20~200μmφ (通常100μmφ)
※微小測定、広域測定については別途ご相談ください |
| 検出深さ |
~約30nm |
| 検出下限 |
1atomic%程度※Li,B,Cなどの軽元素は検出下限が高い傾向 |
| エネルギー分解能 |
Ag3dピークのFWHW≦1.20eV (光電子取出角90度、PE=112eVの時) |
| 大気非暴露 |
Ar雰囲気 |
| スパッタイオン源 |
Arモノマー, GCIB |
| 加熱温度 |
イントロで600℃まで※600℃~は要相談 |
必要情報
- 目的/測定内容
- 試料情報
(1)数量、予備試料の有無等
(2)形状、層構造、膜厚、表裏の判断、破壊可否、加工の有無等
(3)着目元素
- 納期
(1)ご希望の速報納期
(2)注意事項
- その他の留意点
注意点
以下の場合、評価が困難な可能性があります。別途ご相談ください。
- 表面汚染や表面荒れが顕著
- 溝底部等評価部位の周囲に妨害がある(深さ2mm以上)
- 5μm以上の厚膜試料の深さ方向分析
- 昇華性物質、ガス放出が多く著しく真空度を下げる試料
- 磁性物質
- 毒劇物で飛散しやすい形状の試料等
- 絶縁性材料(導電処理により観察可能)
[HAXPES]硬X線光電子分光法の分析事例はこちらからご覧ください。