EBSD : Electron Backscatter Diffraction Pattern
特徴
EBSDを利用して結晶性試料の方位解析ができる手法です。
電子回折法より容易にかつ広い領域の結晶情報を得ることができます。
EBSP: Electron Backscatter Pattern、SEM-OIM、OIMとも呼ばれます。
- 単一結晶粒の面方位の測定が可能
- 結晶粒径観察が可能
- 特定結晶方位の抽出が可能
- 透過法により10nm以上のグレインを評価可能
- 測定領域の配向測定が可能
- 双晶粒界(対応粒界)観察が可能
- 隣接結晶粒の回転角の測定が可能
適用例
- 半導体デバイス金属配線の結晶粒観察
- 金属材料の成長(成膜)技術における最適条件の探索
- ボイド周辺の結晶粒界の調査
- 金断面からのウイスカの配向測定
- SEM装置で格子歪み測定
- ポリSi TFTの結晶解析
- 金属薄膜経時変化の解析
- 合金層中不明層の結晶性評価
- CIGS膜(多結晶太陽電池)の結晶粒評価
原理
約60~70°傾斜した試料に電子線を照射すると、試料表面から約50nm以下の領域の各結晶面で回折電子線が作られます。この後方散乱電子回折を解析することで結晶性試料の方位解析の情報が得られます。
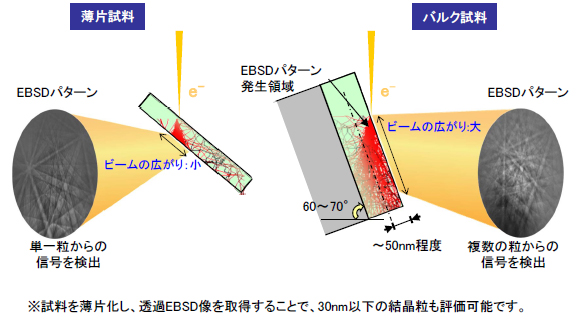
データ例
EBSDパターン:Cu

断面歪み解析結果:SOI層

逆極点図方位マップ:Cu

結晶粒マップ:Cu(透過EBSD)

粒径分布(ヒストグラム):Cu(透過EBSD)

データ形式
- PDFファイル
- PowerPointファイル(オリジナル画像等)
- TEXTファイル(結晶粒径等)
※オリジナル画像とテキストファイルについては必要な場合は別途ご相談ください。
仕様
| 測定実績 | Cu, Si, Al, CIGS, SiC, GaN, Al2O3等 |
| 搬入可能試料サイズ | 数百μm~20mm程度 |
| 測定可能領域 | 1μm×1μm~20mm×20mm |
| 検出深さ | 50nm程度 |
| 分解能 | 数十nm~ (透過法を用いると10nm~) ※SEMプローブ径に大きく依存します。 |
| 倍率 | 50~50,000倍程度 |
必要情報
- 目的/測定内容
- 試料情報
(1)数量、予備試料の有無など
(2)構造、形状、層構造、目的領域材料の結晶構造、膜厚、最表面の情報、加工・観察箇所
試料破壊(切断等)の可否など
(3)注意事項 - 納期
(1)ご希望の速報納期
(2)注意事項 - その他の留意点
注意点
- 分析の際、凹凸の影響を大きく受けます。
- 数十nm以下の結晶粒については検出できない可能性があります。
- 絶縁物試料は帯電を防止するために導電性処理を行います。

![[EBSD]電子後方散乱回折法](https://www.mst.or.jp/wp-content/uploads/2026/02/EBSD_MG_1253.jpg)