SIMS:二次イオン質量分析法
異種材料間の界面位置
異種材料間の界面のSIMS分析プロファイルは、深さ方向にある幅をもって変化します。これはSIMS分析の特性上、イオンビームミキシングとスパッタ表面の凹凸(ラフネス)の影響を受けるためです。検出している不純物は、混ぜ合わされた深さまでの平均化した情報となり、深さ方向に幅を持った領域のイオンを検出します。
そのため、1)界面位置は一般に主成分元素のイオン強度が50%になる位置と定義しています。
AlGaAs/GaAs試料を測定した結果を例に示します。
AlGaAs膜のスパッタレートを用いて深さ変換を行った場合、AlGaAs 中のAluminium の二次イオン強度(1.2E5)が50%(6.0E4)になる深さ約1.0μmを界面位置とみなすことができます。
ただし、3層以上からなる積層構造の試料の場合は、各層によってスパッタレートが異なるため、深さの換算に不確かさが伴いますのでご注意ください。
図1 AlGaAs/As試料のSIMS分析プロファイル
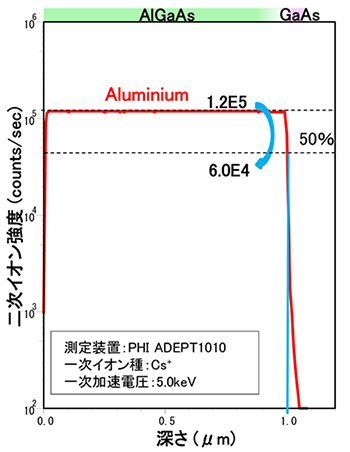
1)参考文献:日本工業標準調査会JIS規格
「JISK0146 表面化学分析-スパッター深さ方向分析-層構造系標準物質を用いた最適化法」
深さ方向分解能
2)深さ方向分解能は、イオン強度が最大強度の84%に相当する深さと、16%に相当する深さの差によって定義しています。
GaAs/AlAs試料を測定した結果を例に、深さ方向分解能の求め方を記載します。
- AlAs膜中Aluminiumの最大強度:9.6E4
- 9.6E4の84%に対応する深さ:約89nm
- 9.6E4の16%に対応する深さ:約95nm
これにより、深さ方向分解能は、
約95nm –約89nm = 約6nm と求めることができます。
深さ方向分解能は、主に一次イオン種やイオンビームミキシングおよび試料表面の凹凸(ラフネス)によって決まります。ミキシングや凹凸が大きいと、深さ方向分解能が劣化し、モニターしている各元素の分布が実際よりも広がって見えてしまいます。
従って、材料や測定条件、試料表面状態によって深さ方向分解能の値は異なりますのでご注意ください。
MSTでは数nm~数十nmの深さ方向分解能で測定を行うことが可能です。
図2 AlGaAs/AlAs試料のSIMS分析プロファイル
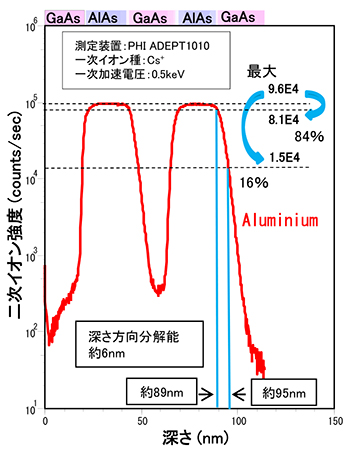
2)参考文献:日本工業標準調査会JIS規格
「JISK0146 表面化学分析-スパッター深さ方向分析-層構造系標準物質を用いた最適化法」
深さ方向分解能と測定間隔の違い
図3 BのSIMS分析プロファイル
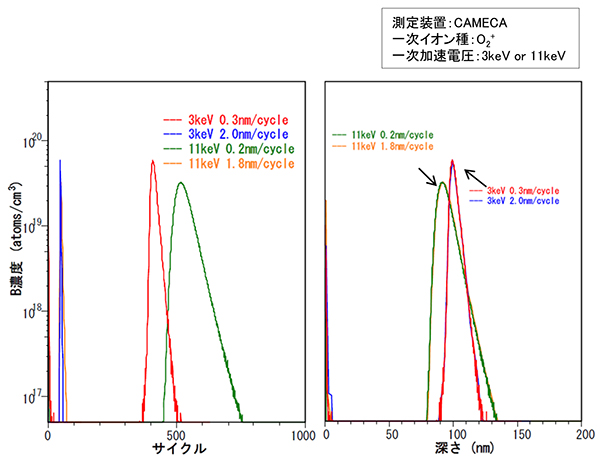
SIMS測定の測定間隔(=深さ/サイクル)は分母のサイクルによって変化し、サイクルはモニターする元素やスパッタレートなどの様々な測定条件によって決定されます。
上図に測定間隔を変化させて深さ方向分解能との関係性を調べた結果を示します。左図は横軸がサイクルです。右図は左図の横軸を深さに変換した図で、深さ方向分解能の違いを表しています。上図より、一次イオンの入射エネルギーが同じであれば、測定間隔を変えても深さ方向分解能はほとんど変わりません。一方、一次イオンの入射エネルギーを小さくすると、深さ方向分解能が向上しています。
以上のことから、高い深さ方向分解能を得るためには、元素の測定間隔ではなく、一次イオンの入射エネルギーを低くすることが重要であることが分かりました。
しかし、入射エネルギーを小さくすると十分な電流密度が得られず、深い位置までの分析や微量元素の高感度分析を行うことが困難となります。よって、実際には測定するトータルの深さと着目層の厚みを照らし合わせながら、適切な条件を選択していきます。