半導体中キャリアの直流電圧依存性評価(C0628)
SMMを用いた計測・データ解析(in situ 測定)
概要
SMM計測は半導体中のキャリア濃度の大小をマッピングできる手法です。また、SMM計測時に試料に直流電圧を印加してキャリアを誘起させながら計測することが可能です。各測定点で印加電圧条件毎にSMM信号を取得しながらマッピング測定を行い、データキューブを構築します。全データ収集後に印加電圧条件ごとにSMM信号を解析することで、印加電圧に対するキャリアの振る舞いを可視化することができます。 本資料では、キャリア濃度既知のSi 試料を用いた解析結果をご紹介いたします。
試料説明データ
キャリア濃度既知のSi試料を用いた直流電圧の多段階調整によるSMM計測
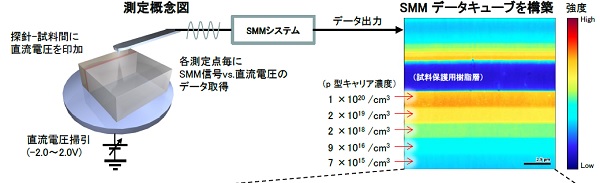
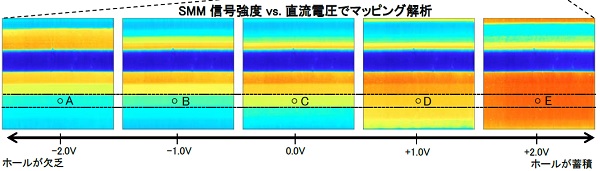
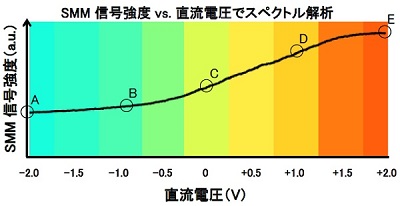
|
p 型のキャリアの振る舞いに関して
直流電圧(-)の場合:SMM強度低下
直流電圧(+)の場合:SMM強度上昇
の関係であることを可視化した
Point
【直流電圧依存性評価】
・半導体中のキャリアの挙動を可視化
・欠陥・異常箇所周辺のキャリアの挙動
評価に有効
|
| MST技術資料No. | C0628 |
|---|
| 掲載日 | 2020/10/01 |
|---|
| 測定法・加工法 | [SMM]走査型マイクロ波顕微鏡法
|
|---|
| 製品分野 | LSI・メモリ
パワーデバイス
光デバイス
太陽電池
照明
酸化物半導体
|
|---|
| 分析目的 | 形状評価
製品調査
|
|---|