ペロブスカイト太陽電池の発光解析(C0730)
非破壊でペロブスカイト太陽電池の発光特性評価や劣化解析が可能です。
概要
ペロブスカイト太陽電池は軽くて柔軟性がある等の観点から次世代の太陽電池として期待されています。有機構造やハロゲン、金属等を含んでおり、これらの組成や結晶性によって様々に性質が変化することがペロブスカイト太陽電池の研究開発の課題の一つとされています。今回は、高温高湿試験を行ったペロブスカイト太陽電池の正常部と異常部で、フォトルミネッセンス(PL)測定装置および蛍光寿命測定装置により発光スペクトルや発光寿命の違いを評価しました。
データ
|
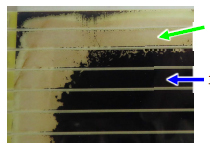
|
➡異常部
高温高湿試験後、水分侵入により色抜けしたところ |
| ➡正常部 |
| 変色した「異常部」と、黒色の「正常部」のそれぞれの箇所について、PL測定および発光寿命測定を実施しました。 |
| ペロブスカイト太陽電池の写真 |
|
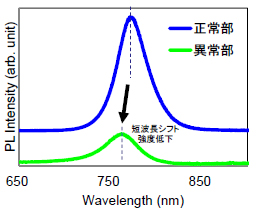
|
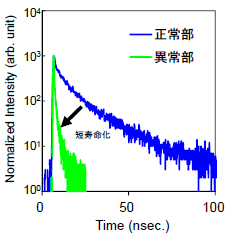
|
Fig.1 ペロブスカイト太陽電池のPLスペクトル
※異常部で発光強度が非常に弱かったため、正常部とは条件を変更して測定しています。 |
Fig.2 ペロブスカイト太陽電池の発光減衰曲線 |
Fig.1の「異常部」と「正常部」を比較するとピーク位置がシフトし、ピーク強度が大きく低下しています。
「異常部」では「正常部」に比べ組成の変化および結晶性の低下等が生じていると推測されます。 |
Fig.2の「異常部」と「正常部」を比較すると発光の減衰曲線が急峻に変化しています。
「異常部」では「正常部」に比べて発光寿命が短い(キャリア寿命が短い)ことが分かります。 |