着目する表面構造によって2手法の使い分けが有効です
概要
走査電子顕微鏡(Scanning Electron Microscope:SEM)及び走査イオン顕微鏡(Scanning Ion Microscope:SIM)は、どちらも二次電子像を得ることで試料表面近傍の構造評価を行う手法です。一次プローブの違いによってコントラストの現れ方や空間分解能などの違いがあり、着目する表面構造によって2手法の使い分けが有効です。本資料では2手法の比較をまとめるとともに、測定例としてCu表面を観察した事例をご紹介します。
データ
走査電子顕微鏡(SEM)と走査イオン顕微鏡(SIM)による二次電子像の比較
| SEM | SIM | |
| 一次プローブ | 電子 | Gaイオン |
| 検出粒子 | 電子 | 電子 |
| 最高分解能 | 0.4nm(加速電圧30kV) | 4nm(加速電圧30kV) |
| 観察倍率 | ~30万倍程度 | ~5万倍程度 |
| 検出深さ | 加速電圧に依存 | 表面近傍(<10nm) |
| 主なコントラストの 要因 |
表面形状・組成 | 結晶方位(チャネリング) |
図 Cu表面の走査電子顕微鏡(左)と走査イオン顕微鏡(右)による二次電子像
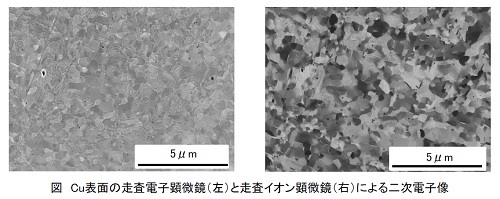
走査イオン顕微鏡(SIM)では結晶方位(チャネリング)による明瞭なコントラストが見られています