第一原理計算によるALD成膜におけるプリカーサ吸着シミュレーション(C0639)
基板上へプリカーサ吸着時の活性化エネルギー、反応熱の情報が得られます
概要
ALD(原子層堆積法)は気相の連続的な化学反応を利用した成膜技術であり、膜厚の厳密なコントロールが可能なことや、低温プロセスでの運用、付き回りの良さなどの理由から、微細加工が求められる半導体分野を中心に広く用いられています。一般に成膜速度が遅いALDにおいて、異なる基板間の成膜速度の差を理解するためには基板上へのプリカーサ吸着メカニズムの解明が求められます。本資料では第一原理計算によって異なる基板上のプリカーサ吸着シミュレーションを行った事例を紹介します。
データ
基板-プリカーサ間の反応について

※ダングリングボンドは水素で終端
基板上のプリカーサ吸着シミュレーション

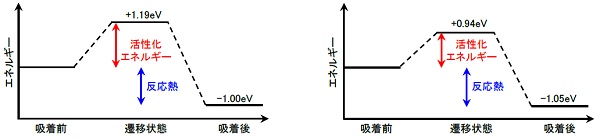

| MST技術資料No. | C0639 |
|---|
| 掲載日 | 2020/11/19 |
|---|
| 測定法・加工法 | 計算科学・AI・データ解析
|
|---|
| 製品分野 | LSI・メモリ
酸化物半導体
|
|---|
| 分析目的 | 構造評価
その他
|
|---|