分子動力学計算による Ga含有プリカーサーの蒸気圧計算(C0738)
ALD、CVDのプリカーサーに用いられる金属錯体の蒸気圧予測に有効
概要
ALD(原子層堆積法)は高アスペクト比の構造に対しても原子層レベルで均一な成膜が可能なため、半導体の微細化・複合化・細線化に有用な方法として着目されています。成長表面における「原料(プリカーサー)の吸着飽和を利用した気相プロセスによる成膜方法であるため、基板へのプリカーサーの被覆率、成膜レートを向上させるためには、高い蒸気圧を持ったプリカーサーが求められています。本資料では分子動力学計算により種々のGa含有プリカーサーの蒸気圧を予測し、実験値と比較しました。
データ
ALDウインドウ
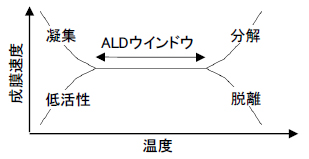 |
プリカーサの表面反応は温度が低すぎる状態では、反応が進まなかったり、高すぎる状態では飽和吸着がされないといった成膜異常に繋がる挙動を示す可能性があります。理想的な温度帯では、温度を変化させても成膜速度が変化せず、反応が自己制御できます。この温度帯をALDウインドウと呼びます。プリカーサーの蒸気圧は、成膜プロセスの設計、品質に関わるため、指定の温度帯における蒸気圧の評価は重要です。
|
Gaプリカーサーの蒸気圧計算結果
気液平衡系の分子動力学計算を用いて、Ga含有プリカーサーの蒸気圧を予測しました。
| プリカーサー |
ペンタメチルシクロ
ペンタジエニルガリウム
(GaCp*) |
トリエチルガリウム
(TEG) |
トリメチルガリウム
(TMG) |
| 構造 |
 |
 |
 |
| 蒸気圧(計算) |
0.39 kPa(50℃) |
0.60 kPa(20℃) |
19.8 kPa(20℃) |
| 蒸気圧(実験)[1] |
0.16 kPa(50℃) |
0.58 kPa(20℃) |
23.7 kPa(20℃) |
予測された蒸気圧は実験値と良く一致しており、種々のプリカーサーへの適用が期待できます。
[1]水谷文一表面技術(2023) 74 151
| MST技術資料No. | C0738 |
|---|
| 掲載日 | 2025/08/07 |
|---|
| 測定法・加工法 | 計算科学・AI・データ解析
|
|---|
| 製品分野 | LSI・メモリ
パワーデバイス
製造装置・部品
酸化物半導体
|
|---|
| 分析目的 | 熱物性評価
|
|---|