HAXPESによるオージェピークの重複を回避した評価(B0273)
Ga線(HAXPES)およびAl線・Mg線(XPS)測定によるスペクトル比較
概要
HAXPESでは励起光に硬X線(Ga線)を用いており、通常のXPS測定で用いられるAl線・Mg線とはオージェピークの位置が異なります。そのため、Al線・Mg線測定において光電子ピークとオージェピークが重複した試料でも、Ga線測定ではその重複を回避でき、詳細な結合状態評価が可能です。
本資料では、Ga線(HAXPES搭載)およびAl線・Mg線(XPS搭載)で測定した、コバール(Fe,Ni,Coの合金)およびGaNのスペクトルを紹介します。
事例1 コバール(Fe,Ni,Coの合金)
■Ga線(9.25keV, HAXPES) :ピークの重なりが無く、詳細な評価が可能

■Al線(1.49keV, XPS):Fe,Coの酸化物ピーク位置に、Co・Ni, Feオージェピークが重なる

■Mg線(1.25keV, XPS):OにCoオージェピークが近接する

事例2 GaN
Ga線を用いたHAXPESでは、オージェピークの重複回避に加え、表面酸化・表面有機汚染の影響が少ない測定が可能です。(※Ga線O1sおよびC1s参照)
これはAl線・Mg線の検出深さが~8nmであるのに対し、HAXPESの測定深さが~50nm程度となるためです。
■Ga線(9.25keV, HAXPES):ピークの重なりが無く、詳細な評価が可能

■Al線(1.49keV, XPS):NにGaオージェピークが重なる
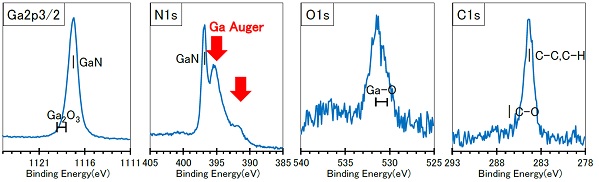
■Mg線(1.25keV, XPS):CにGaオージェピークが重なる
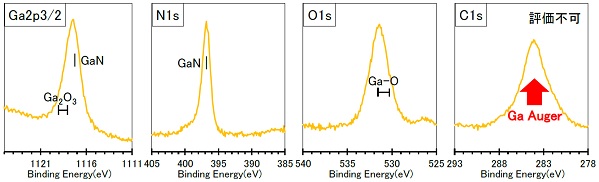

Niに重複するFオージェピーク、Mnに重複するNiオージェピーク(二次電池正極他)等の回避も可能です。
(関連資料:C0659)
二次電池正極の結合状態評価(C0659)の
分析事例はこちらからご覧ください。