ウェハ上パーティクルの組成分析(C0736)
SEM-EDXによる形状観察及び簡易定量分析
概要
半導体ウェハ製造プロセスにおけるパーティクルの制御は、ウェハの品質を担保する上で非常に重要です。本事例では、Siウェハ上パーティクルのSEM観察及びEDX分析と簡易定量(※1)によって、パーティクルが何かを推定しました。サブミクロンの高い空間分解能を持ち、数cmの領域を走査できるSEM装置では、形状及び組成情報からウェハ上のパーティクルが何かを速やかに推測でき、発生工程を素早く特定することができます。欠陥検査装置の座標データとリンクした分析も可能です。
データ
Siウェハ上のパーティクルをSEM観察及びEDX分析しました。SEM観察により500nmφ程度の大きさのパーティクル表面に数十nmの凹凸構造が確認できました。また、EDX分析と簡易定量による組成情報
から、O,F,Al とわずかなMg が確認され(※2)、パーティクルは主にアルミナがフッ化されたものであると推測できました。
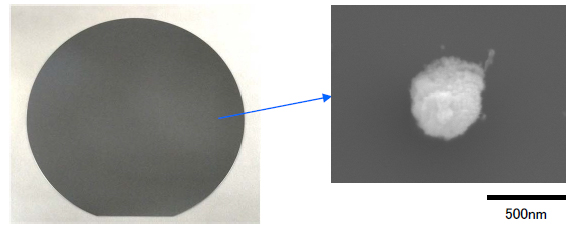 図1.分析対象のウェハ全景写真(左)及びパーティクルのSEM観察結果(右)
図1.分析対象のウェハ全景写真(左)及びパーティクルのSEM観察結果(右) 図2.パーティクルのEDX分析スペクトル結果
図2.パーティクルのEDX分析スペクトル結果
表1.簡易定量結果
| 元素 |
原子数濃度(%) |
| C |
19 |
| O |
16 |
| F |
48 |
| Mg |
1 |
| Al |
6 |
| Si |
11 |
※1 濃度既知の標準試料を用いない簡易的な計算による組成計算結果(原子数濃度(%))です。
※2 Cは測定時の試料汚染、Siは基板成分の為、これらを除いて考察しています。